传台积电已将2.5D封装技术CoWoS部分流程外包给日月光等OSAT
共 1911字,需浏览 4分钟
· 2021-11-28

11月26日消息,据台湾《电子时报》援引业内人士称,台积电已将2.5D封装技术CoWoS (Chip On Wafer On Substrate)封装业务的部分流程外包给日月光(ASE)、矽品、安靠(Amkor)等 OSATs,尤其是一些需要小批量定制的高性能芯片,台积电只在晶圆层面处理 CoW 流程,而将oS(On Substrate,简称oS)流程外包给OSATs,类似的合作模式预计将在未来的3D IC封装中继续存在。
CoWoS技术先将芯片通过Chip on Wafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板连接(oS)。其中oS流程无法实现自动化的部分较多,需要更多人力,而日月光、矽品、安靠等顶尖OSAT厂商在oS流程处理方面的经验更多。
“先进封装”升级跃迁,台积电采用灵活模式与 OSATs 合作
“先进封装”也是一个长期变化的概念,每个时代的“先进封装”都意味着一次技术体系革新。例如,过去DIP、SOP、TSOP、QFP、LQFP等技术被看作传统封装时,BGA、CSP、FC、MCM(MCP)等技术就会被称为“先进封装”。
台积电于2012年推出了CoWoS封装技术,但由于成本较高而难以推广。随后又推出了主要针对手机芯片的InFO封装技术,采用聚酰胺薄膜代替CoWoS中的硅中介层,从而降低了单位成本和封装高度。CoWoS和InFO先进封装解决方案,为台积电的先进工艺之虎插上双翼。
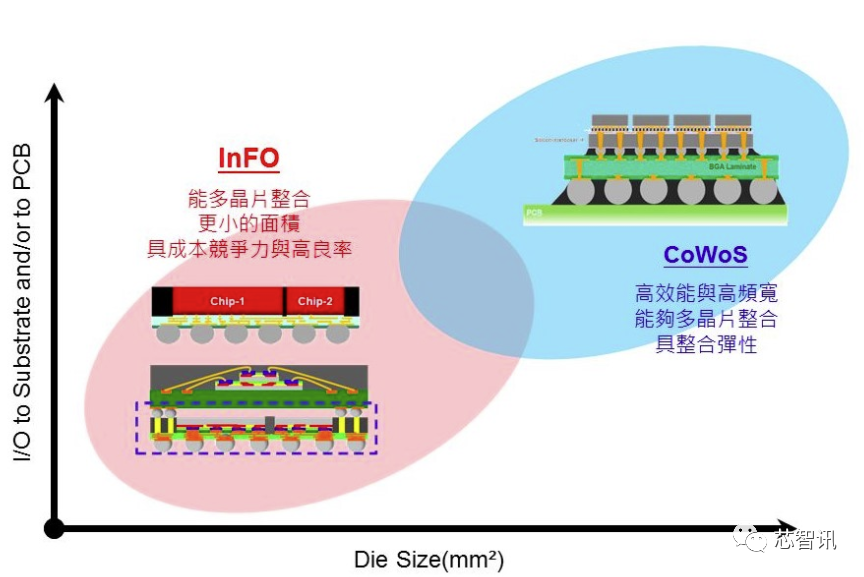
图源:DIGITIMES
而时下的“先进封装”,就是平面封装向2.5D/3D堆叠异构集成封装技术的升级跃迁。
Yole Developpement 预测,先进封装市场预计将在 2019-2025 年间以 6.6% 的复合年增长率增长,到 2025 年将达到 420 亿美元。
在异构集成的竞争中,日月光、台积电、英特尔、Amkor 和 JCET 等主要参与者宣布了 2021 年前所未有的资本支出投资:
台积电计划在 2021 年花费大约 25至 28 亿美元的资本支出,以配备基于 InFO 的设备、CoWoS 和基于 SoIC 的产品线的新先进封装工厂。台积电通过其先进封装产品在 2021 年创造了约 36 亿美元的收入,并有望在顶级 OSAT 集群中达到新的高度。
日月光还宣布了估计 20 亿美元的资本支出,专门投资于通过 EMS 活动蓬勃发展的系统级封装业务及其晶圆级封装业务。在收购 SPIL 和 USI 之后,ASE 仍然是顶级的 OSAT。
英特尔将投资大量资金用于先进封装,以扩大其在亚利桑那州和俄勒冈州工厂的 Foveros/EMIB“混合”封装制造。
在封装业务方面,台积电最赚钱的是晶圆级SiP技术,如CoW和WoW,其次是FOWLP和InFO,而oS的利润最低。之前台积电也会将部分封装业务的oS流程外包给上述OSAT厂商,包括使用FOWLP和InFO封装工艺的HPC芯片。
异构芯片集成需求将显著增长,预计台积电采用更灵活的模式与 OSATs 合作。该上述人士强调,即使台积电最新的 SoIC 技术在未来得到广泛应用,代工厂和 OSATs 之间的合作仍将继续,因为 SoIC 和 CoWoS 一样,最终将生产出“晶圆形式”的芯片,可以集成异质或同质芯片。台积电目前还采用无基板的 Infou PoP 技术,对采用先进工艺节点制造的 iPhone APs 进行封装,强大的集成制造服务有助于从苹果获得大量订单。
来源:电子工程专辑 综合自智通财经网、联合新闻网、驱动中国、雪球、超能网等
突发!美国将国科微、国盾量子、新华三半导体等12家中企列入“实体清单”
创疆投资收购LPE被否决后,意大利政府再度否决一起中资半导体收购案
全球安防50强公布:这家中国公司为何能成为唯一上榜的CIS企业?
行业交流、合作请加微信:icsmart01
芯智讯官方交流群:221807116
